随着手机制造业不断发展,以及人们使用需要不断提高,现在手机摄像头的各项参数已经相当高了,并且很多手机现在都配备多个摄像头。手机摄像头由CMOS组件、塑料件、透镜等部件构成,这些部件粘接固定都需要用到电子胶水。
摄像头模组组件器件包括一下几类:1.光学镜头LENS2.图像传感器SENSOR 3.AF驱动组件 4.镜座HOLDER 5.红外滤光片IR FILTER 6.PCB板(FPC) 7.连接器CONNECTOR 8.周边电子元件

模组的组装,主要有以下方式:
1.CSP:Chip Size Package 芯片尺寸封装
简称CSP(Chip Size Package或Chip Scale Package)。CSP是一种封装外壳尺寸最接近籽芯(die)尺寸的小型封装;CSP有两种基本类型:一种是封装在固定的标准压点轨迹内的,另一种则是封装外壳尺寸随芯尺寸变化的。常见的CSP分类方式是根据封装外壳本身的结构来分的,它分为柔性CSP,刚性CSP,引线框架CSP和圆片级封装(WLP)。柔性CSP封装和圆片级封装的外形尺寸因籽芯尺寸的不同而不同;刚性CSP和引线框架CSP封装则受标准压点位置和大小制约。
CSP Chip Scale Package封装的优点在于封装段由前段制程完成,制程设备成本较低、制程时间短,面临的挑战是光线穿透率不佳、价格较贵、高度较高、背光穿透鬼影现象;
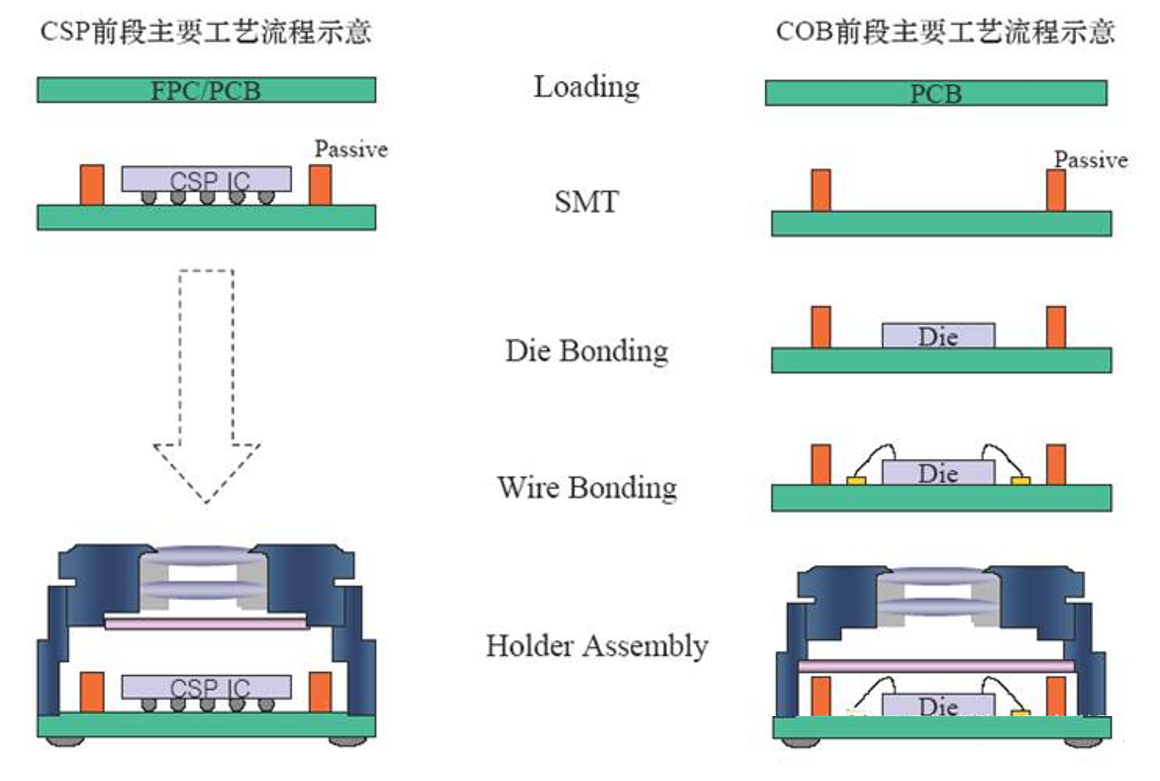
2.COB:Chip On Board
用COB技术封装的裸芯片是芯片主体和I/O端子在晶体上方,在焊接时将此裸芯片用导电/导热胶粘接在PCB上,凝固后,用 Bonder 机将金属丝(Al或Au)在超声、热压的作用下,分别连接在芯片的I/O端子焊区和PCB相对应的焊盘上,测试合格后,再封上树脂胶。
与其它封装技术相比,COB技术有以下优点:价格低廉;节约空间;工艺成熟。COB技术也存在不足,即需要另配焊接机及封装机,设备成本较高、良品率变动大、制程时间长,有时速度跟不上;PCB贴片对环境要求更为严格;无法维修等。
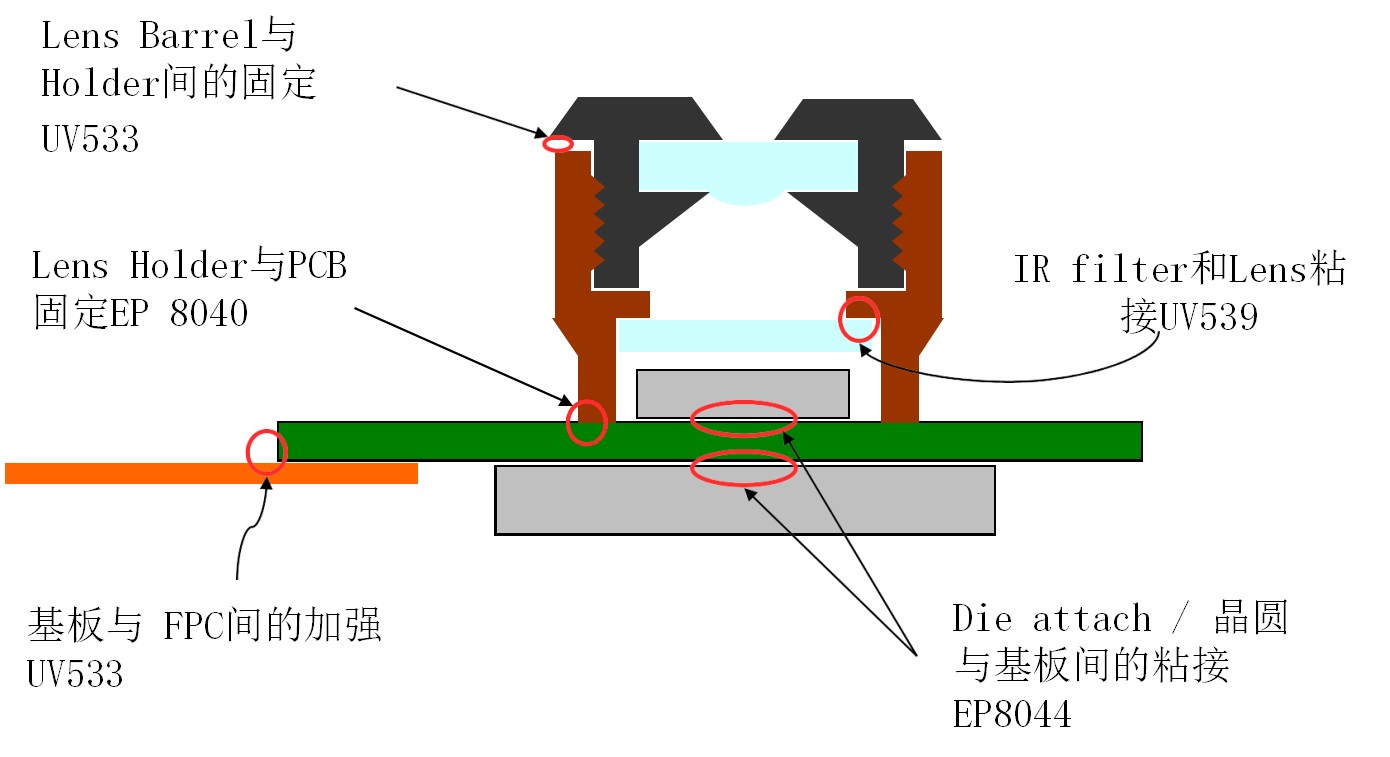
整个制程下来,需要用到胶水的位置非常多,其中每个位置的要求有有着非常大的差别。另外摄像头模组的点胶,要求精度非常高。以holder位置的粘结为例,这个位置的用胶,主要有以下要求:
1、应用于产品摄像头模组与PCB的加固贴合;
2、在四边拐角上点胶水,形成保护堰;
3、增强CMOS模组和PCB的贴合强度;
4、分散和降低因震动所引起的突点张力和应力;
5、避免传统用胶的高温烘烤,避免对元器件损害或影响其性能
推荐使用东信低温固化胶EP8044,这是低温加热固化环氧树脂类胶粘剂,80℃固化,适用于多种材料的粘结。本品具备高附着力,低吸水率,良好的贮存稳定性。主要应用于摄像头模组CCD/COMOS边框的粘结,适用于对温度敏感的元件的粘接